TDKのコアテクノロジー
Vol.5
「MEMS技術」と小型マイクロフォン

電子機器には多種多様なセンサが活用されていますが、近年、華々しく活躍しているのは、MEMS(メムス/Micro Electro Mechanical Systems:微小電気機械システム)と呼ばれるテクノロジーを活用したMEMSセンサ。MEMSとは、半導体素子の微細加工技術を応用・発展させ、シリコン基板上にセンサを回路や可動機構などと一体化して量産する技術です。スマートフォンにも、MEMSマイクやモーションセンサ、気圧センサなど、各種MEMSセンサが搭載され、小型・軽量化とともに、さらなる多機能・高機能化に貢献しています。
半導体技術から派生して生まれたMEMSデバイス
米国西部のモニュメントバレーは、映画ロケ地としても有名な観光スポット。大地から約300mもの高さでそそり立つ岩山は、スペイン語で「テーブル、台」という意味の「メサ」と呼ばれています。ICやLSIのルーツとなったメサ型トランジスタという名称は、このメサに由来します。

初期の点接触型や接合型トランジスタを経て、1950年代後半から1960年代かけてトランジスタの主流となったのは、メサ型トランジスタと呼ばれるタイプ。シリコン基板(当初はゲルマニウム基板)の上にN型およびP型の拡散層(不純物のドープによりN型半導体やP型半導体にした領域)を形成し、不要な部分をエッチングで削り取ったメサ(台形)構造となっています。このメサ型トランジスタをベースとして発明されたのが、画期的なプレーナ型トランジスタです。
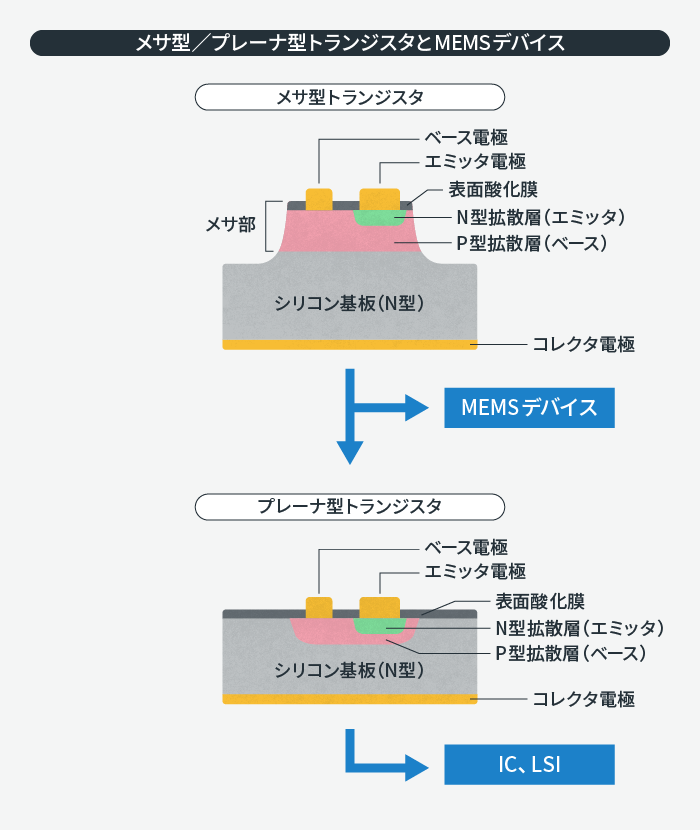
メサ型はPN接合面がエッチングによって露出してしまうため、保護膜による処理が必要で、信頼性にも難がありました。そこで、フォトリソグラフィを駆使した平面(プレーナ)プロセスにより、PN接合面を安定した酸化膜で平面的に覆うことで、特性や信頼性、量産性をいちだんと向上させたのがプレーナ型です。1960年代からはプレーナ型トランジスタが主流となり、さらにコンデンサや抵抗なども同じシリコン基板に集積することでICやLSIが発明されました。
その一方で、シリコン基板を深く掘ったり、複雑な構造体を形成したりする高度なエッチング技術も派生的に発展し、MEMSという新たな技術分野が立ち上がりました。
MEMSのキーテクノロジー
初のMEMSデバイスは、1970年代に米国スタンフォード大学が、NASAからの委託を受け、火星の大気分析用に開発した探査機用の小型ガスクロマトグラフ装置といわれます。以後、インクジェットプリンタのヘッド、自動車用の圧力センサや加速度センサなど、民生分野でも多種多様な製品が開発されるようになりました。MEMSデバイスはマイクロマシンとも呼ばれるように、従来の機械加工の限界をブレイクスルーして、革新的な小型化を実現したからです。

MEMSデバイスの製造プロセスにおけるキーテクノロジーとなるのは、フォトリソグラフィ、エッチング、そして堆積法です。
フォトリソグラフィは写真製版技術とも呼ばれるように、写真現像のプロセスを応用させた微細加工技術です。シリコン基板にレジスト(感光性材料)を塗布し、フォトマスクをかぶせて紫外線などで露光・現像すると、マスクパターン通りにレジストが残ります。これをエッチング処理して立体構造を形成したり、あるいは金属その他の材料を堆積して、電極や機能性薄膜、回路などを作製したりします。フォトファブリケーションと呼ばれるこのプロセスをシリコン基板上で繰り返すことで、複雑な機構をもつMEMSデバイスが実現できます。
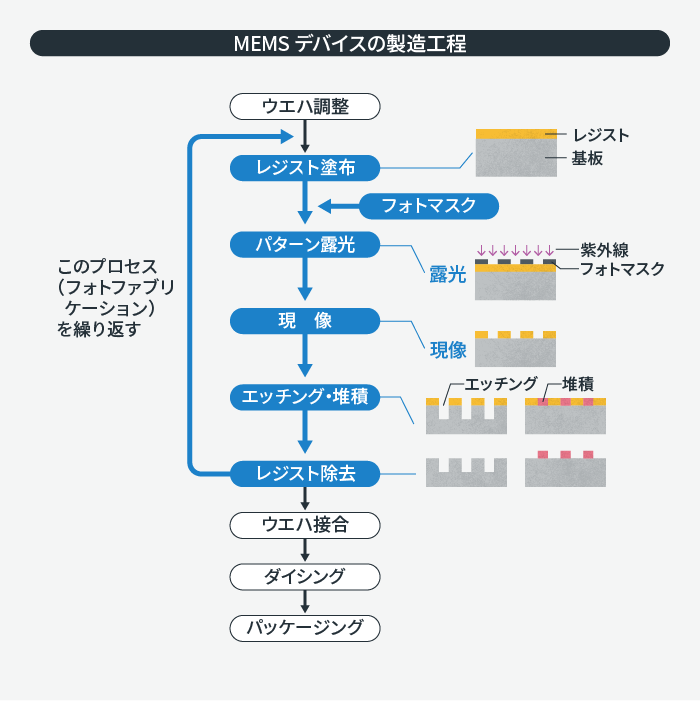
ウェットエッチングとドライエッチング
MEMSデバイスの製造プロセスにおいて、特に重要なのはエッチング技術です。もともとエッチングというのは、銅版画や凹版印刷における用語です。防蝕剤を塗布した銅板をニードル(鋭い鉄筆)で線画を描き、これを腐蝕液に浸すと、線画部分だけが溶けて溝状になります。そこにインキを詰めて印刷するのが銅版画や凹版印刷です。紙幣の肖像や模様などの印刷にも使われています。
MEMSプロセスにおけるエッチングには、ウェットエッチングとドライエッチングがあります。ウェットエッチングは、銅版画のエッチングと同様に、パターン露光・現像されたシリコン基板をエッチング液に浸す方法です。エッチング液に浸す時間が長くなると、溝が深くなるとともに横方向にも進行し、しだいに洞窟状に広がります。これを等方性エッチングといいます。
エッチングの断面をきれいなV字型やテーパ状にすることもできます。シリコンなどの結晶はエッチングされやすい面方向とされにくい面方向があることを利用したもので、これは結晶異方性エッチングと呼ばれ、MEMSマイクやMEMS気圧センサなどにおけるキャビティ(空洞)形成の基本技術となっています。
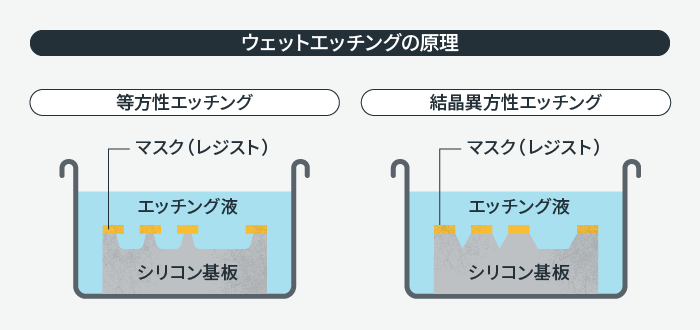
異方性エッチング:シリコン結晶にはエッチングされやすい面方向と、されにくい面方向がある。これを利用すると、V字型やテーパ状にエッチングできる。エッチング液はアルカリ(水酸化カリウムなど)。
細い縦溝のような加工も可能にするDeep-RIE技術
エッチング液を用いず、ガスやプラズマなどの気相で行われる工法をドライエッチングといい、これも等方性と異方性に大別されます。
等方性ドライエッチングは、反応性の高いガスや、ガスをプラズマ化して生成したラジカルとイオンを、シリコンと化学反応させ、その反応生成物を除去してエッチングする方法です。
また、化学反応によらずイオンを電界で加速し、基板表面に叩きつけて物理的にエッチングする方法を異方性ドライエッチングといいます。基板表面を垂直にエッチングしたい場合に利用されます。
フッ素(F)や塩素(Cl)などの反応性イオンを用いる異方性ドライエッチングはRIE(反応性イオンエッチング)といい、とりわけアスペクト比(溝幅と深さの比)の高い深掘り構造に適用される技術はDeep-RIEと呼ばれます。これは掘り孔の側壁に保護膜を形成しながら掘り進むという技術で、アスペクト比が100前後にも及ぶ深掘りも可能にします。この技術はバイオやメディカル分野でも注目されていて、細胞に穿刺(せんし)してDNAなどを注入できる中空構造のマイクロニードルなども開発されています。
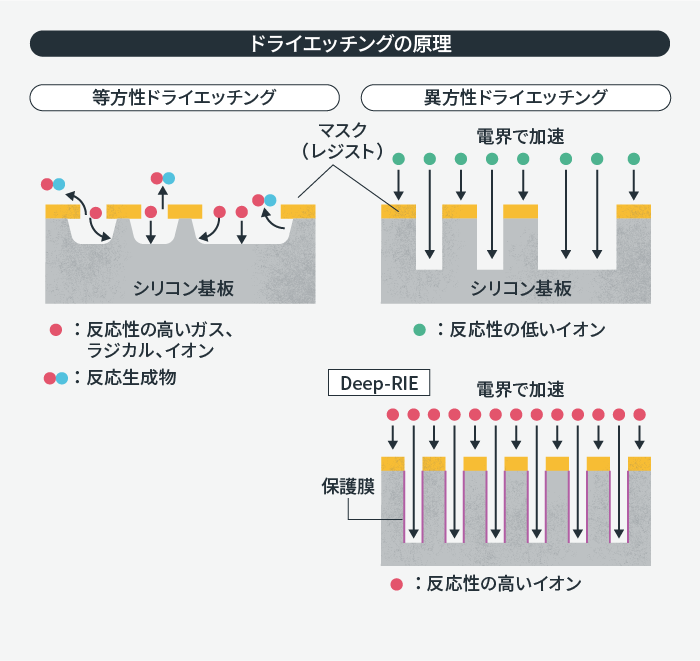
マイクロアクチュエータなどを可能にする犠牲層エッチング
エッチングの中でも、微細な可動機構などを形成するための技術が、犠牲層エッチングと呼ばれるMEMS技術です。たとえば、シリコン基板上に、シリコン酸化膜などで犠牲層を形成し、さらにそれを覆うように多結晶シリコンで構造層を形成してから、等方性エッチングにより犠牲層を除去すると、片持ち梁(はり)状や中空状など、立体的な構造体がつくれます。また、それぞれ単独の機能が搭載され、かつ、キャビティ構造を持ったシリコンウェハーをウェハーレベルで貼り合わせることで、気密性を兼ね備えた中空構造を形成する技術も用いられます。これは加速度センサやジャイロセンサの可動部の作成などに利用されています。
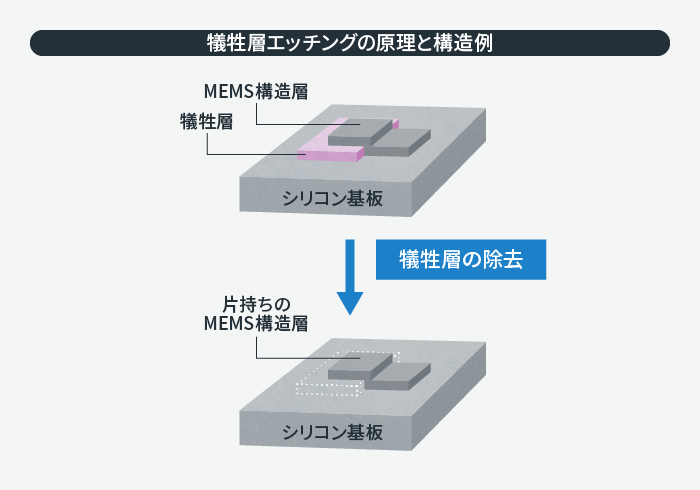
シリコン基板上に犠牲層と構造層を形成してから、等方性エッチングにより犠牲層を除去すると、片持ち梁(はり)状や中空状など、立体的な構造体がつくれる。
構造層や配線層を実現する電解めっきなどの堆積法
不要部分を取り去るエッチングとは逆に、基板上に金属やその他の材料層を積み上げる技術を堆積法といいます。代表的な物理的気相堆積法としては、スパッタ法などがあります。これらはタッチパネルや液晶ディスプレイなどの機能性薄膜の形成技術として、さまざまな分野で活用されています。
液相堆積法の代表は電解めっきです。電解めっきは電気分解と逆の原理により、溶液中の金属イオンを電極に移動させて析出させる技術で、エレクトロプレーティング(電鋳:でんちゅう)とも呼ばれます。電解めっきの長所は、薄膜から厚膜まで簡単かつスピーディに作成できること。薄膜電子部品である薄膜コイルなども、こうした方法で製造されています。
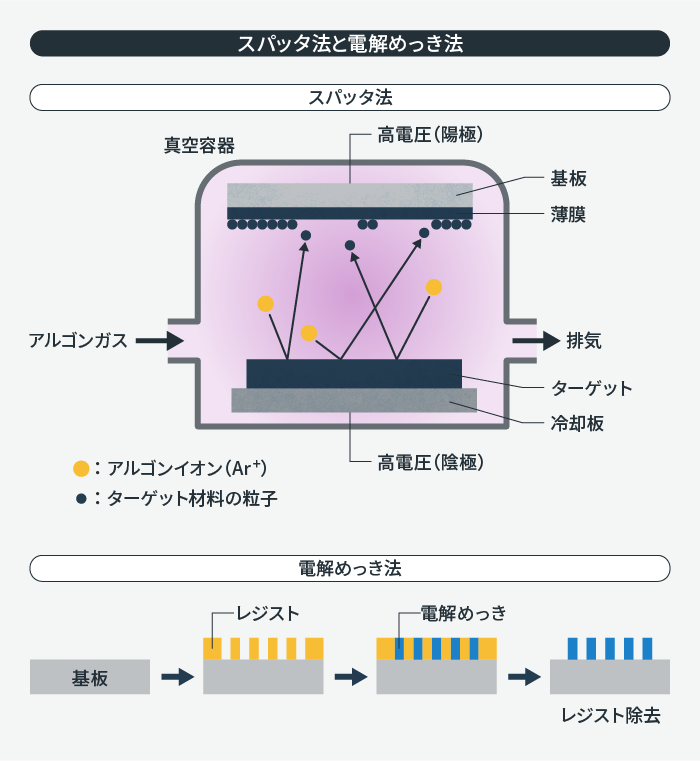
スマートフォンやスマートスピーカなどに使われるMEMSマイク
MEMSデバイスの一例として、スマートフォンなどに使われているMEMSマイクについて解説します。
かつて携帯電話などにはエレクトレットマイク(誘電分極を長期にわたり保つ特殊な誘電体を用いたマイクロフォン)が使われてきました。しかし、エレクトレットは高分子材料(テフロンなど)であり、部品を一括はんだ付けするリフロー炉の高温では誘電分極を失ってしまうなどの弱点があり、やむなくあとから別に取り付けられていました。
この問題を解決して、エレクトレットマイクにかわって採用されるようになったのがMEMSマイク。シリコン基板上のMEMSプロセスで製造される、超小型・高性能・SMDタイプのマイクロフォンです。
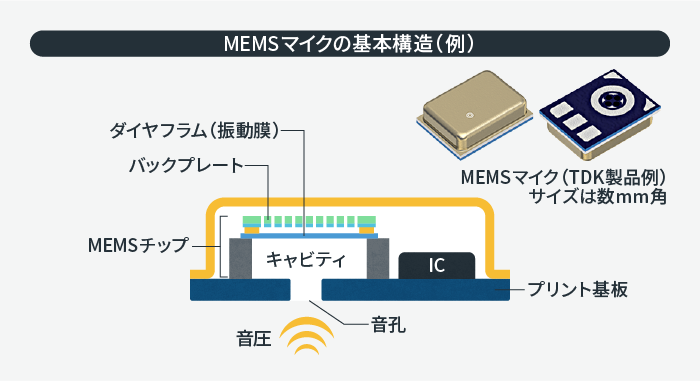
MEMSマイクの原理は、スタジオ録音など使われるコンデンサマイクと同じく静電容量型と呼ばれるもので、シリコン基板のエッチングによって作製したキャビティ(空洞)と振動板、そして振動板とわずかな空隙をあけて対向するバックプレートからなります。音圧が音孔からキャビティに伝わると、振動板が動いてバックプレートの電極との間の静電容量が変わるので、これを信号として検出します。
こうして量産されたMEMSチップは、ICなどとともにパッケーシングされてMEMSマイクとなります。

TDKはInvenSenseブランドおよびTDKブランドの各種MEMSマイクを提供しており、スマートフォンやタブレット、対話型ロボットであるスマートスピーカ(AIスピーカ)などに多用されています。
半導体微細加工技術を応用発展させたMEMS技術は、先進のセンサ&センシングデバイスを支える主要技術としても発展を遂げています。TDKは音センサであるMEMSマイクのほか、圧力センサや気圧センサ、加速度センサやモーションセンサ、超音波センサなど、各種MEMSセンサおよびデバイスを豊富にラインアップ。ソフトウエア技術などとも融合させた多彩なセンサソリューションを提供しています。
TDKは磁性技術で世界をリードする総合電子部品メーカーです




